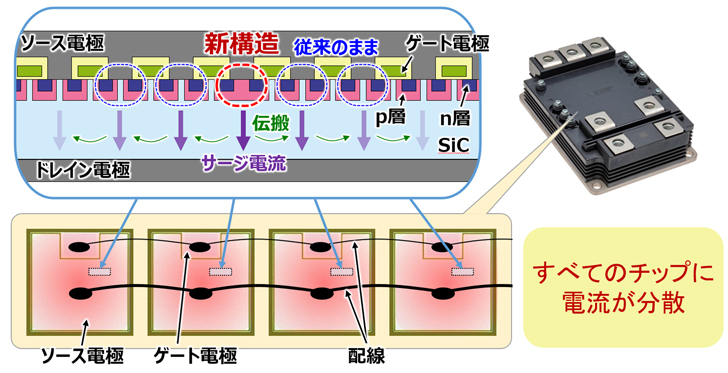
三菱電機株式会社は、サンプル提供を5月31日に開始した鉄道車両・直流送電などの大型産業機器向け3.3kVフルSiC※1パワーモジュール「FMF800DC-66BEW※2」において、新構造のSBD※3内蔵SiC-MOSFET※4を適用しました。これにより、鉄道車両用推進制御装置などの小型化や省エネルギー化、直流送電の普及促進などを通じてカーボンニュートラルの実現に貢献します。
近年、電力損失を大幅に低減できるSiCパワー半導体への期待が高まっており、当社はSiC-MOSFETやSiC-SBDを搭載したSiCパワーモジュールを2010年に製品化して以来、エアコンや鉄道車両などさまざまなインバーターシステムにSiCパワー半導体を適用してきました。
SiC-MOSFETとSiC-SBDを一体化したSBD内蔵SiC-MOSFETは、両者を別チップにした従来技術と比べて、パワーモジュールに搭載するチップを高密度に実装できるため、パワーモジュールの小型化や大容量化が可能なうえ、スイッチング損失の低減が図れることから、機器の小型化、省エネルギー化が求められる鉄道車両・直流送電などの大型産業機器への普及が期待できます。一方、SBD内蔵SiC-MOSFETを用いたパワーモジュールは、接続した回路でサージ電流※5が発生すると、特定のチップのみにサージ電流が集中し、チップの熱破壊が生じてしまうことから、従来のSiパワーモジュールよりもサージ電流耐量※6が低くなり、実用化が難しいという課題がありました。
当社は今回、パワーモジュール内の並列接続されたチップ構造において、サージ電流が特定のチップへ集中するメカニズムを世界で初めて※7解明し、すべてのチップが一斉に通電を開始してサージ電流が各チップ内全域に分散する新チップ構造を開発しました。これにより、サージ電流耐量を当社従来技術と比べて5倍以上に向上し、従来のSiパワーモジュールと同等以上のサージ電流耐量が得られたことで、パワーモジュールへのSBD内蔵SiC-MOSFETの適用を実現しました。
なお、本開発成果の詳細は、香港で5月28日から6月1日に開催された「ISPSD※8 2023」で、5月31日14時(現地時間)に発表しています。
- ※1
Silicon Carbide:炭化ケイ素
- ※2
2023年5月8日広報発表 https://www.MitsubishiElectric.co.jp/news/2023/pdf/0508.pdf
- ※3
Schottky Barrier Diode:半導体と金属の接合部に生じるショットキー障壁を利用したダイオード
- ※4
Metal Oxide Semiconductor Field Effect Transistor:金属酸化膜半導体製の電界効果トランジスタ
- ※5
回路からパワーモジュールに対し、定格電流を超える電流が瞬間的に流れる突発的な動作
- ※6
サージ電流が発生した場合にパワーモジュールが耐えられる限界電流
- ※7
2023年6月1日現在、当社調べ
- ※8
International Symposium on Power Semiconductor Devices and ICs:パワー半導体に関する国際会議
